MEMS・半導体製造装置
マイクロテクノロジーの未来へ躍進
住友精密は、MEMS製造に欠かせないシリコン深掘り装置とシリコン酸化膜犠牲層エッチング装置のリーディングカンパニーとして、パートナー企業とともに様々なソリューションを提供できるプロセス装置群をお届けし、MEMS技術の発展に貢献しています。
- 「MEMS(微小電気機械システム)」とは
-
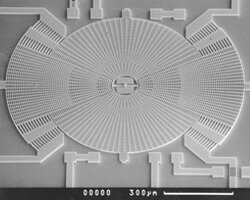 MEMSセンサ(Robert Bosch GmbH殿提供)
MEMSセンサ(Robert Bosch GmbH殿提供)SOIやシリコンなどのウェーハに、ミクロ単位で立体的な加工を施すことで、基板上に回路だけでなく、機械的に動く構造体を構成したデバイスで、身近な電子機器などに搭載されています。
エアバッグ用などの自動車向けセンサ、インクジェットプリンタのノズルヘッド、スマートフォンなどのモバイル機器の高周波デバイスやカメラモジュールなど、その他、様々な分野で研究開発がなされています。
MEMS・半導体装置部門の強み
- シェア90%を誇るMEMS用シリコン深掘り装置
- 世界最高レベルのエッチレート、高マスク選択比、高アスペクト比加工が可能
- 豊富な半導体・MEMS製造装置ラインアップで試作から量産まで対応
シリコン深掘り装置
MEMS用シリコン深掘り装置のデファクトスタンダードです。研究試作型のSRE機から量産型標準のPegasus機、さらに加工精度や生産性を高めた、Predeus機まで、各種の用途に合わせた装置を取り揃えています。
世界最高の高エッチレート、高マスク選択比、高アスペクト比加工という優れたパフォーマンスを最大限に発揮するハードウェアモジュールとプロセスソフトウエアを搭載しており、ジャイロセンサや加速度センサの加工など、様々な用途でお使いいただいています。

- シリコン深掘り装置
CPX ASE-Proxion
- シリコン深掘り装置

- ジャイロセンサ構造 [写真提供:SSP]

- 高アスペクト比エッチング
犠牲層エッチング装置(シリコン、シリコン酸化膜)
微小可動部を有するMEMSの製造に特有の工程として、犠牲層の除去があります。ウェットエッチングで生じる構造体の付着を生じさせることなく加工することが可能な、シリコン酸化膜の等方性ドライエッチング装置です。
簡易手動型からクラスタ型までの搬送系をラインアップし、研究試作から量産まで対応可能です。シリコンマイクや光デバイスなど、様々な用途でお使いいただいています。

- シリコン酸化膜犠牲層エッチング装置
MLT SLE-Ox
- シリコン酸化膜犠牲層エッチング装置

- シリコンマイク構造
[写真提供:Sensfab]
- シリコンマイク構造

- SOIウェーハBOX層エッチング
[写真提供:パナソニック]
- SOIウェーハBOX層エッチング
その他 製造装置
化合物半導体をはじめ、光デバイスなど難エッチング材料を高速でエッチングすることが可能な化合物・酸化膜エッチング装置や、低ストレスシリコン窒化膜や厚膜シリコン酸化膜の形成用途に最適なプラズマ成膜装置なども手掛けています。

- 化合物・酸化膜エッチング装置 APSシリーズ

- プラズマ成膜装置 Cetus
- 主要な装置
-
- 酸化膜/窒化膜エッチング装置
- SiCエッチング装置
- プラズマダイシング装置
- 熱処置装置
- プラズマCVD装置
- 金属膜スパッタ装置(PVD)
- 分子気相成膜装置(MVD)
- ミニマル装置
マルチチャンバ対応のプラットフォーム
量産対応・生産性向上には、高速搬送による高スループットが 可能な真空カセット型プラットフォームと大気カセット型プラットフォームをラインアップしています。
マルチチャンバ化が可能で、真空カセット型では最大3チャンバ(VPXシリーズ)、また4チャンバ(CPXシリーズ)、一方大気カセット型では最大2チャンバ(DPXシリーズ)の搭載が可能です。

- シリコン深掘り装置
CPX ASE-Pegasus
- シリコン深掘り装置

- シリコン酸化膜犠牲層エッチング装置
VPX SLE-Ox
- シリコン酸化膜犠牲層エッチング装置

- シリコン深掘り装置
DPX ASE-Pegasus
- シリコン深掘り装置