

Si深掘り加工技術
Deep Si etching
当社は、現代のMEMS製造に不可欠な『ボッシュプロセス』の共同開発パートナーであり、Si加工のパイオニアです。
1995年に世界初の実用的な装置をリリースして以来、長年にわたり蓄積してきた知見を活かし、高精度・高難度なシリコン深掘り加工において比類なき技術力を提供しております。
Si深掘り加工(Si DRIE)は、MEMSシリコン加工において不可欠な基盤技術です。当社では、長年培ってきた装置技術とプロセスノウハウを活かし、Si深掘り加工を用いたMEMSデバイスの設計検討から試作・評価、量産準備までを一貫して支援しております。
Si深掘り加工(Si DRIE:Deep Reactive Ion Etching)は、MEMSシリコン加工において用いられるシリコンエッチング技術であり、
シリコン基板を高い異方性で深く加工することで、微細かつ高アスペクト比構造の形成を可能にします。
微細構造や深掘り形状が求められるMEMSデバイスにおいて、Si DRIEは中核となる加工技術として広く用いられています。
加工の実現可能性や最適な加工条件について、開発の初期段階からご相談いただけます。
Si深掘り加工には、Robert Bosch GmbH社によって開発されたBoschプロセスが用いられます。
Boschプロセスは、エッチング工程とパッシベーション(側壁保護膜形成)工程を高速に切り替えながら行うシリコンエッチング方式です。
この切り替え制御により、側壁を保護しながら深掘り加工を行うことができ、高アスペクト比加工や微細構造形成を実現します。
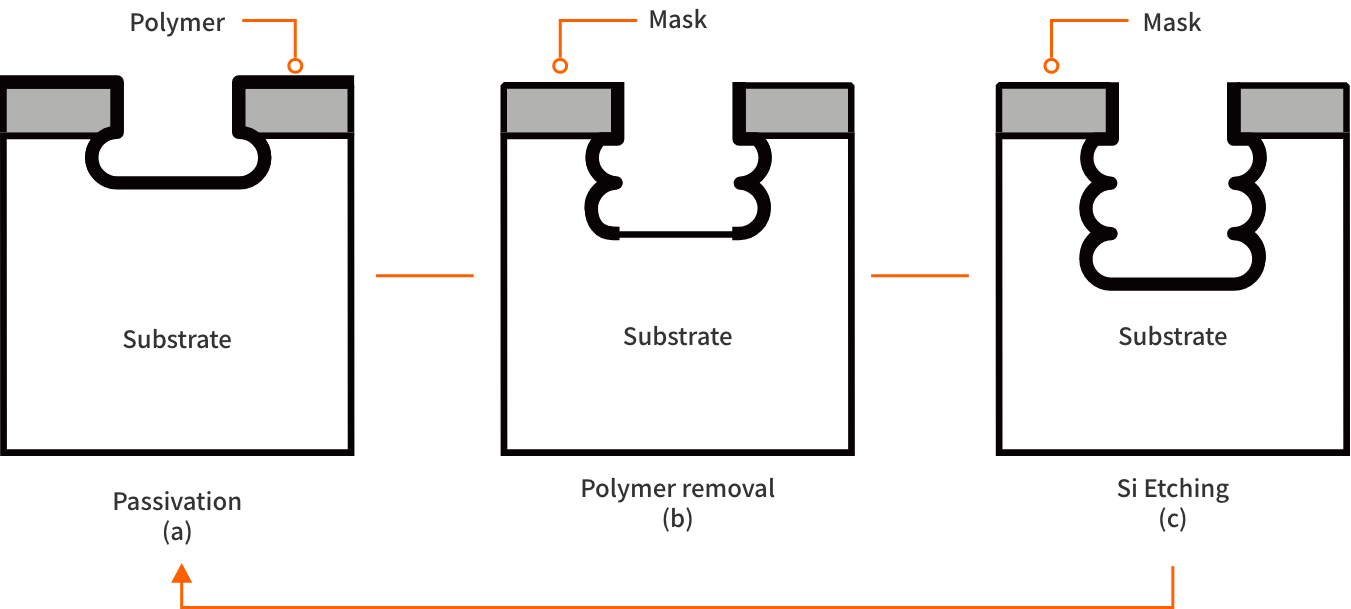
Si深掘り加工(Si DRIE)では、微細な開口幅を維持したまま深さ方向に加工を進める高アスペクト比加工が求められます。
このような加工では、エッチレート、形状再現性、側壁品質といった複数の要素を高いレベルで両立させることが重要となります。
装置性能およびプロセス制御技術の継続的な進化により、当社は、高アスペクト比加工における加工安定性と再現性を向上させてきました。
これにより、MEMSシリコン加工において要求される複雑かつ高精度な構造形成を可能としています。
当社グループ開発装置の機能向上により、Si深掘り加工におけるエッチレートは大幅に向上しています。これにより、加工時間の短縮と生産性向上を両立しつつ、高精度なMEMSシリコン加工が可能となっております。
プロセス開発においては、エッチレート・形状制御性・深さ均一性のバランスに優れたPredeusを中心に運用しており、高難度な加工条件にも安定して対応しています。

装置およびプロセス制御技術の進化により、Si深掘り加工における形状制御性も飛躍的に向上しています。
200mmウエハにおいても、エッジ3mmまでTilt角度0.1°以下を安定して再現することが可能です。
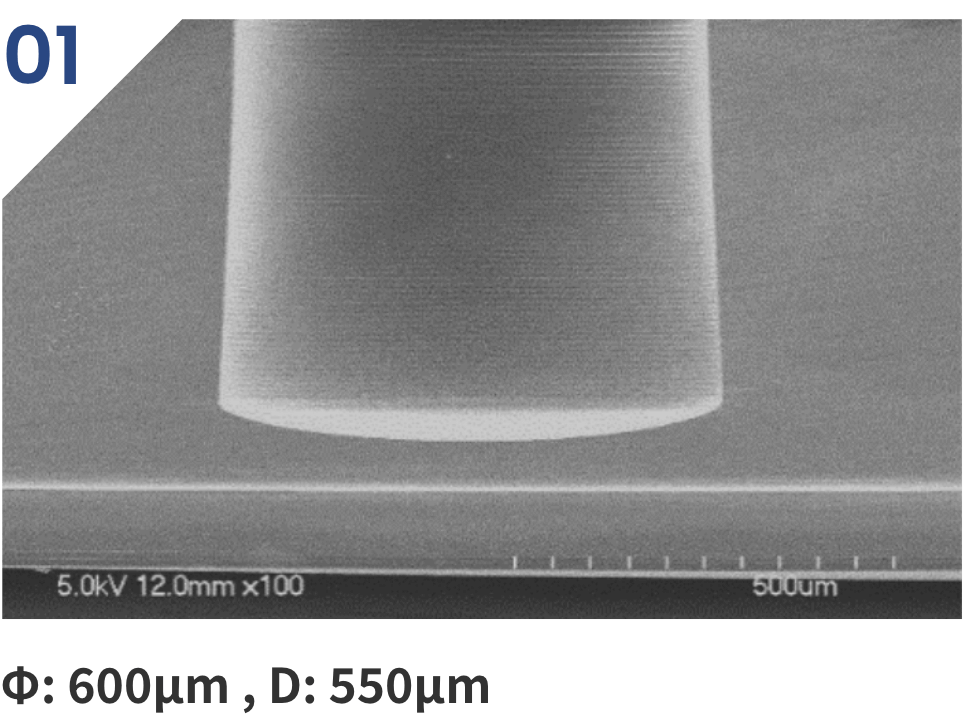
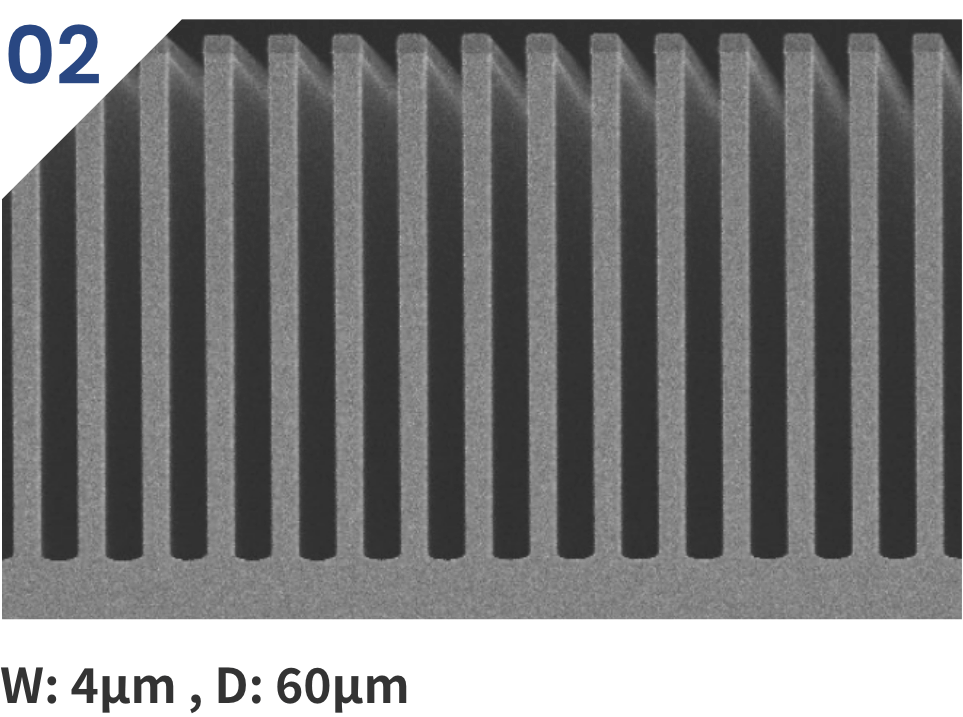
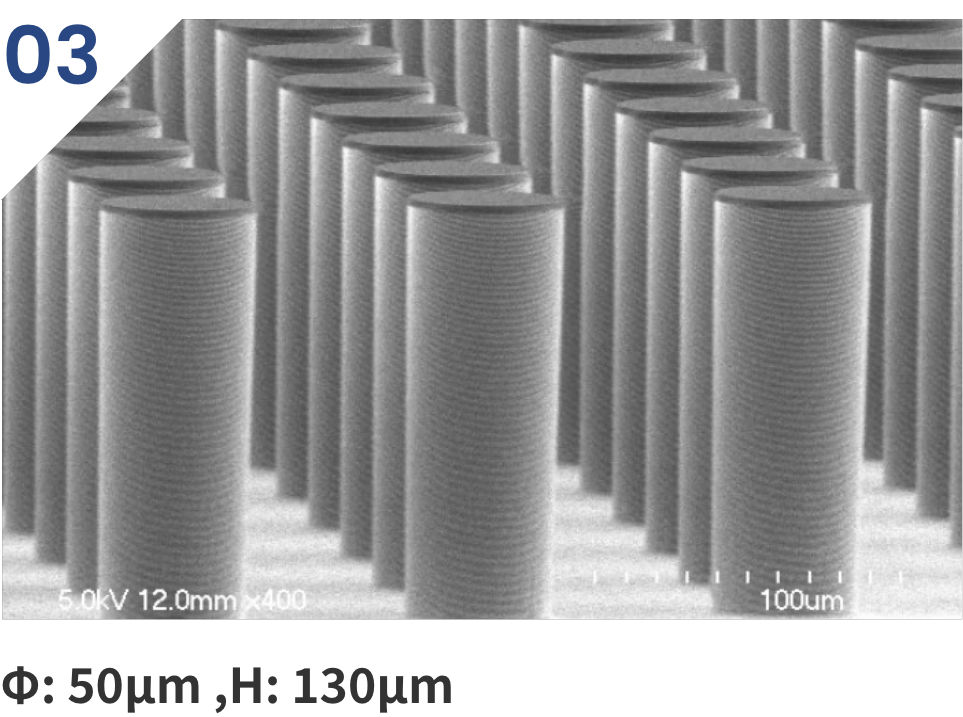
自社開発装置の形状制御性が高まり、深掘り加工を行っても安定した形状を再現できます。
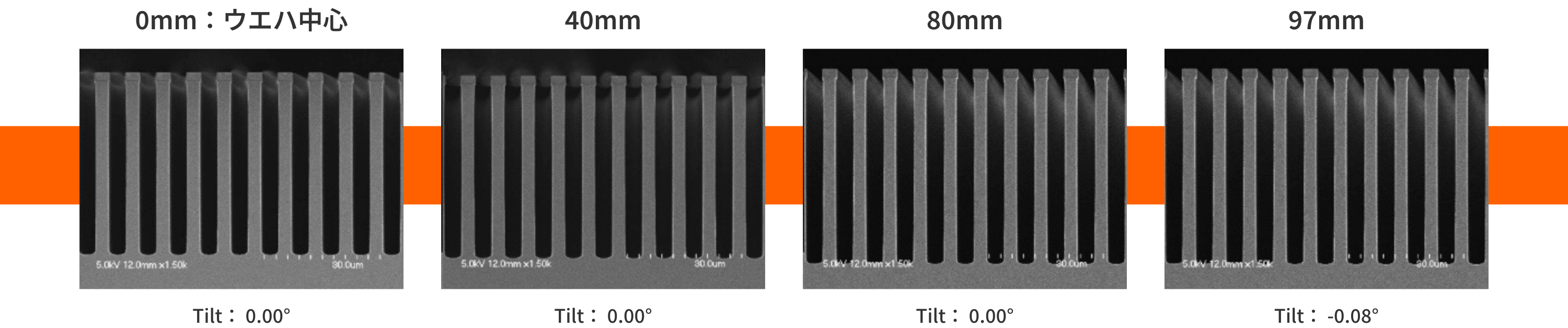
200mmウエハのエッジ3mmまで、
Tilt角度 0.1°以下を安定して再現
Up to 3mm from the edge of 200mm wafer:
Stable control of tilt angles within 0.1° or less
高速スイッチング制御により、加工が深くなっても側壁粗さ16nmを維持し、低スキャロプスによる高品質なシリコンエッチングを実現しています。
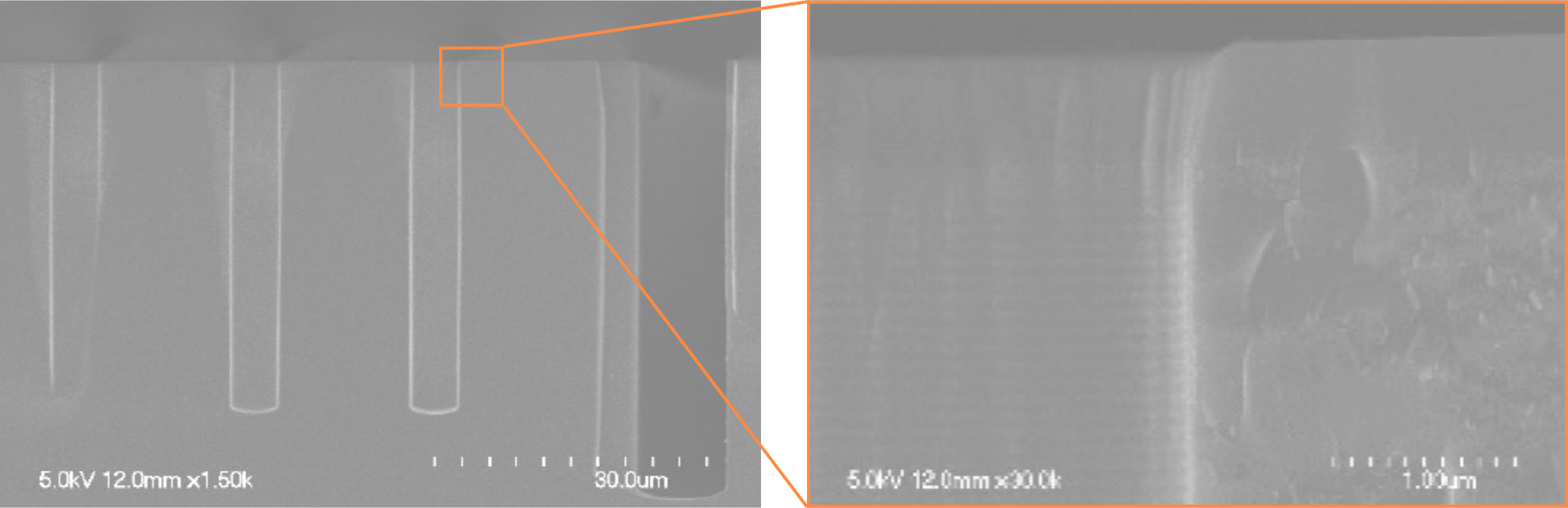
(側壁粗さ16nm、40μm深さ)
SOIウエハ加工時に課題となる酸化膜界面でのノッチを低減し、3μm幅・100μm深さという条件下でオーバーエッチ30%を加えても、酸化膜界面でのサイドエッチング(ノッチ)を生じることなく、シリコンの深掘り加工が可能です。
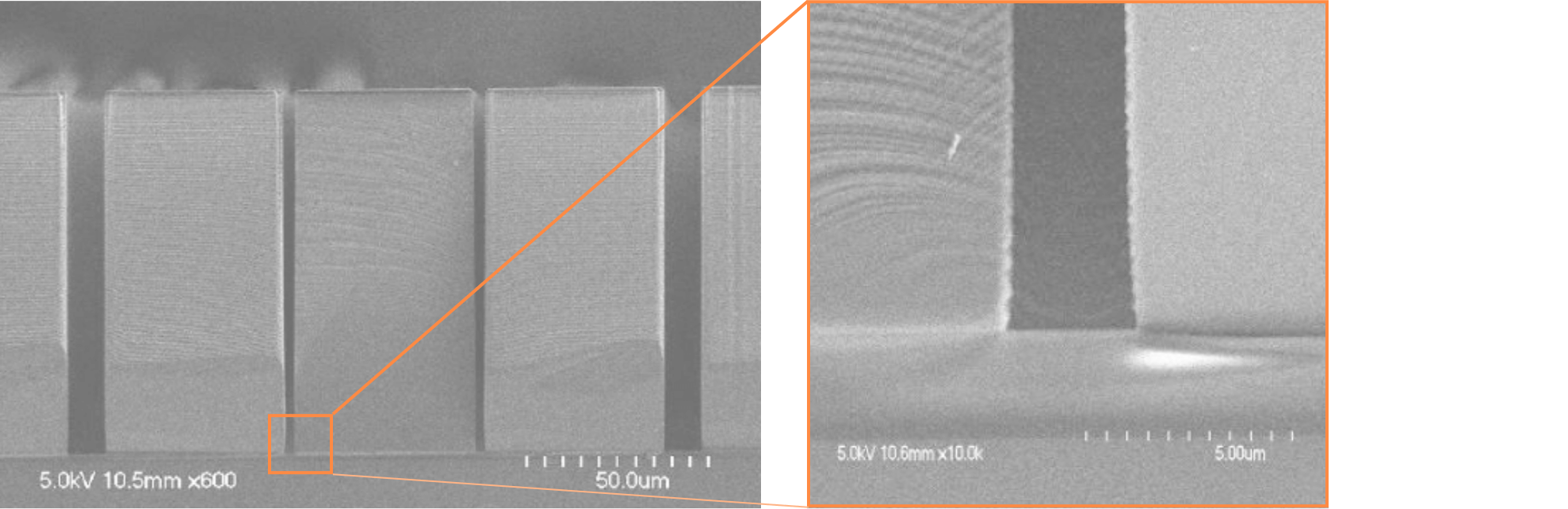
(3μm幅、100μm深さ、オーバーエッチ30%)
パラメータランピング技術を活用することで、5μm幅・200μm深さ(アスペクト比40)といった高いアスペクト比加工においても、角度のズレや蛇行を抑えた均一なシリコン深掘り加工を実現しています。
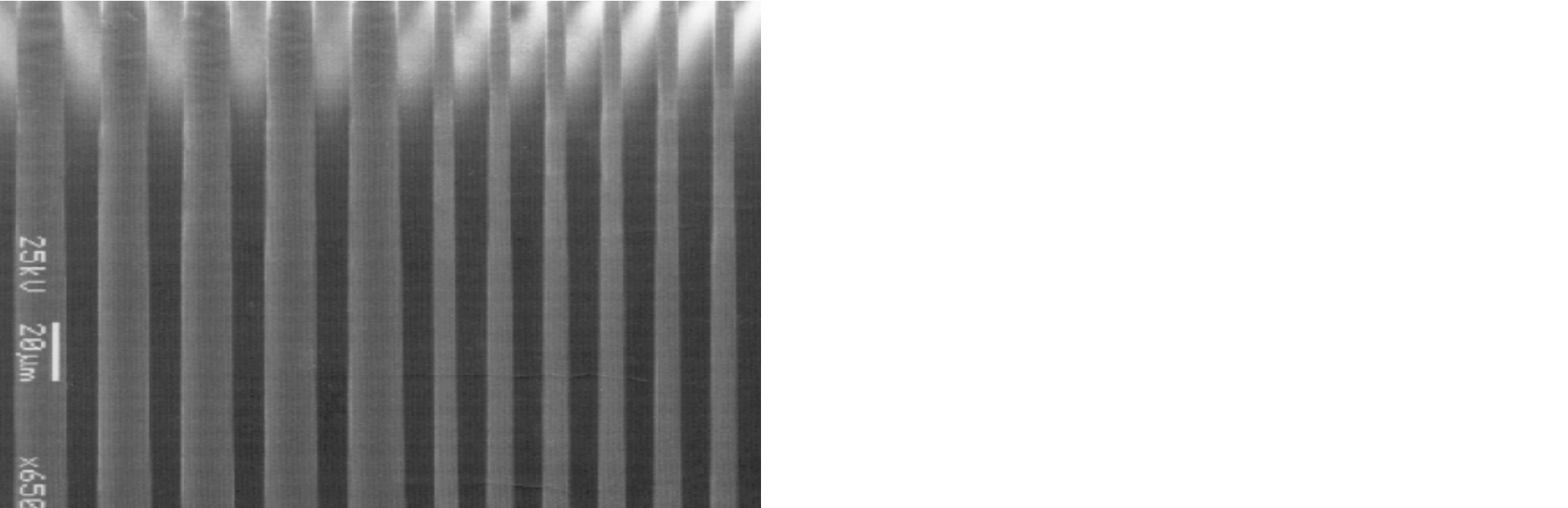
(5μm幅、200μm深さ、アスペクト比40)
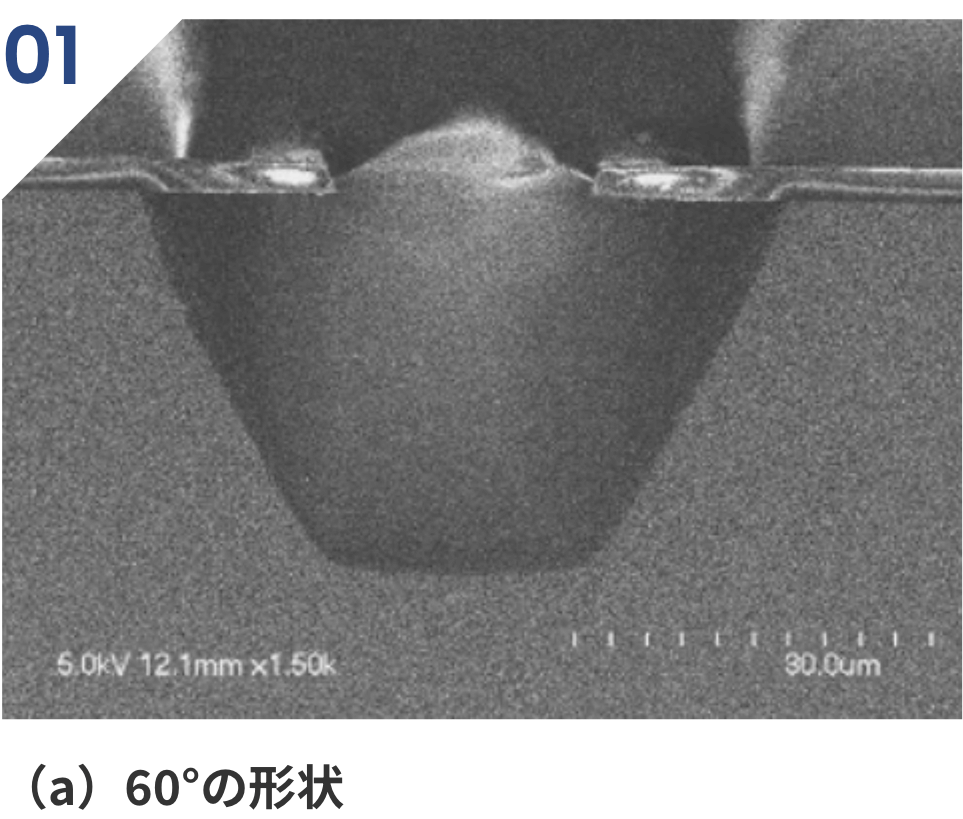
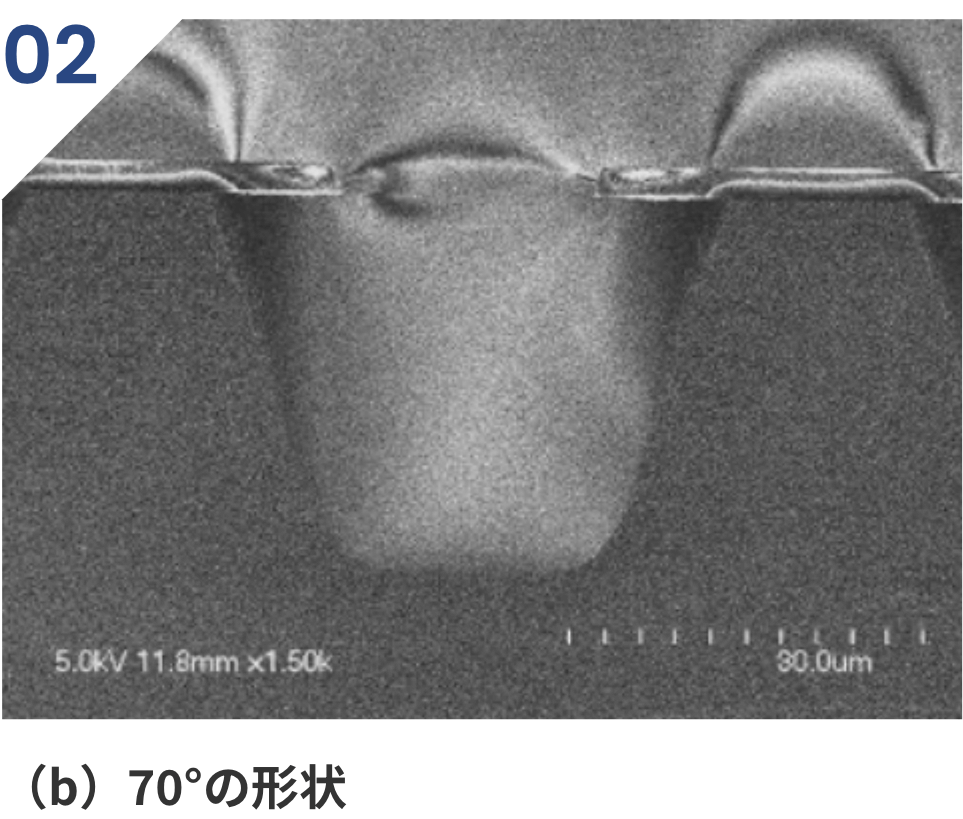
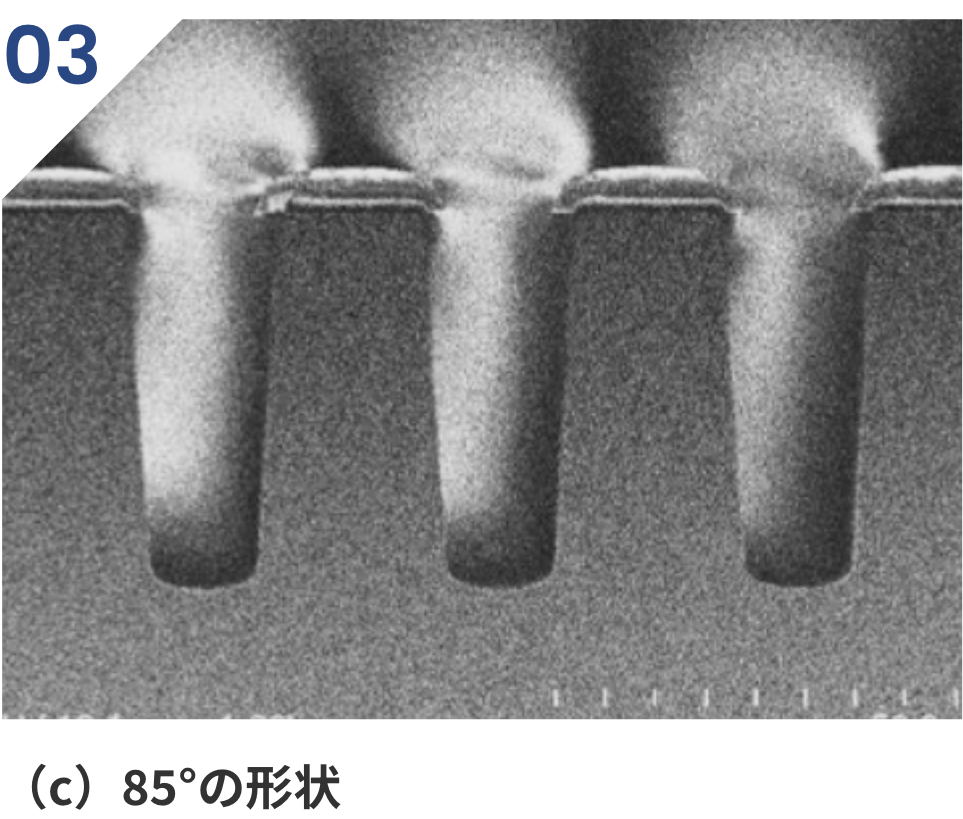
Si DRIEは、MEMSシリコン加工に加え、TSV(Through Silicon Via)形成にも応用されています。
高アスペクト比かつ高精度なシリコン深掘り加工が可能なため、3D実装や高密度配線を支えるTSV加工にも対応可能です。
当社では、試作段階での加工条件出しから、量産移行を見据えたプロセス検討・評価までを一貫して支援し、MEMS開発や実装における技術課題の解決をサポートしております。





